200元2022-11-25 08:09:44
硅片规格有多种分类方法,可以按照硅片直径:4寸、6寸、12寸、3英寸、2英寸;单晶生长方法:单晶硅片、多晶硅片;掺杂类型:N型、P型等参量和用途来划分种类。
硅片加工的具体加工内容
承接0.05mm-2mm各种激光切割、开孔钻孔、划线、开槽、异形切割、盲孔盲槽定制。
应用及市场
太阳能行业单晶硅、多晶硅、非晶硅带太阳能电池片和硅片的划片(切割、切片)。
激光切割于传统机械切割硅片相比,是一种行的加工方式,有一下几点加工优势:
1、激光加工一步即可完成的、干燥对的加工过程。
2、边缘光滑整齐,不需要后续的清洁和打磨。
3、激光加工的分离过程产生高强度、自然回火的边缘,没有微小裂痕。使用激光加工避免了不可预料的裂痕和残破,提高了成品率。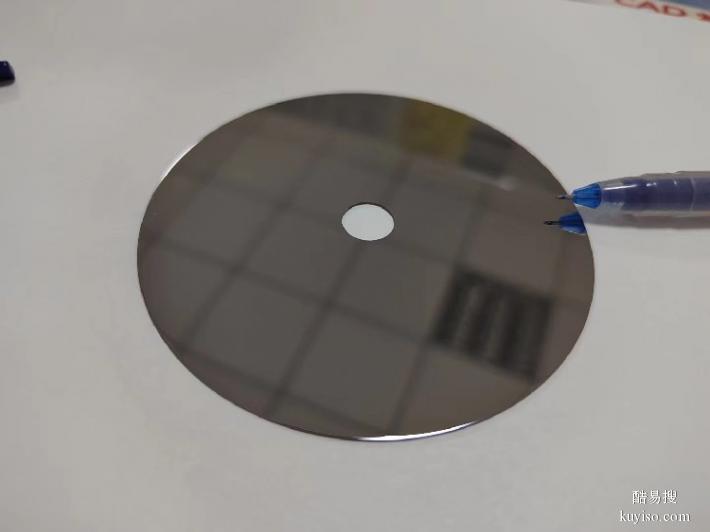
晶圆是半导体产品与芯片的基础材料,半导体芯片产业的激光应用工艺将会越来越多被发明出来,对于高精密的芯片产品,非接触的光加工是最合适的方式。因此激光晶圆(硅片)切割的应用会越来越多。
超薄硅片打孔是一项非常精细的工序,因为硅片较薄,打孔的时候不能损坏其表面的精度,打孔的密度、孔径大小需要达到一定的精度以及所要求的大小。
激光打孔是将光斑直径缩小到微米级,从而获得高的激光功率密度,几乎可以在任何材料实行激光打孔。其特点是可以在硬度高、质地脆或者软的材料上打孔,孔径小、加工速度快、效率高。
超薄硅片使用激光打孔可以打出小孔:1.00~3.00(mm);次小孔:0.40~1.00(mm);超小孔:0.1~0.40(mm);微孔:0.01~0.10(mm);
随着硅半导体集成电路的广泛应用,硅半导体集成电路都要用到晶圆,传统的晶圆切割方法,都是手工采用金刚石刀进行切割,在晶圆上划分出若干个圆环,在划分出的圆环上切割出面积相等或者近似相等的小圆弧体。或者采用的是非均匀圆环、同一圆心角内进行切割的切割方法,这种晶圆切割方法的耗材大,经常要更换刀具,切割出来的晶圆芯片相距的宽度比较大,不均匀,所能切割的材料单一,适用性差,效率低下。
因此晶圆激光切割的方法工作效率高、能精确地调整待切割晶圆的各个方向的位置、精度高、全自动运行,对晶圆切割的位置进行准确定位,切割出来的晶圆芯片均匀、美观,能切割多种材料,适应性强,可以避免薄晶圆因切割破裂