200元2022-12-12 08:11:29
激光划片机主要用于金属材料及硅、锗、砷化镓和其他半导体衬底材料划片和切割,可加工太阳能电池板、硅片、陶瓷片、铝箔片等,工件精细美观,切边光滑。采用连续泵浦声光调Q的Nd:YAG激光器作为工作光源,由计算机控制二维工作台,能按输入的图形做各种运动。输出功率大,划片精度高,速度快,可进行曲线及直线图形切割。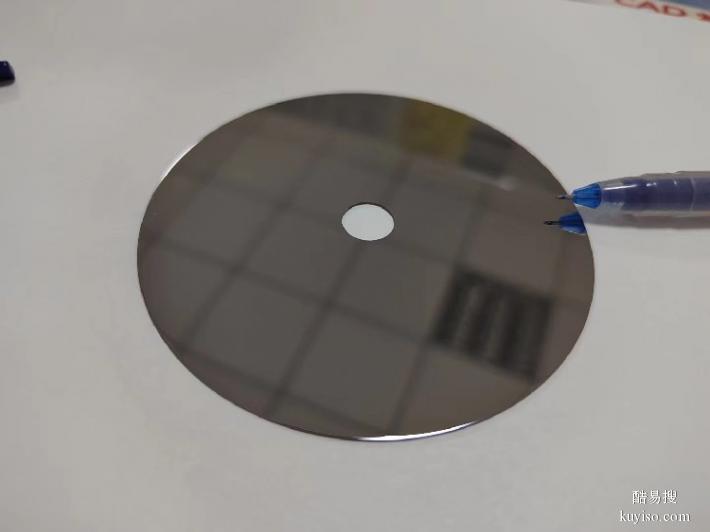
硅片的分类:
硅片规格有多种分类方法,可以按照硅片直径:4寸、6寸、12寸、3英寸、2英寸;单晶生长方法:单晶硅片、多晶硅片;掺杂类型:N型、P型等参量和用途来划分种类。
晶圆是半导体产品与芯片的基础材料,半导体芯片产业的激光应用工艺将会越来越多被发明出来,对于高精密的芯片产品,非接触的光加工是最合适的方式。因此激光晶圆(硅片)切割的应用会越来越多。
1.激光切割、划片是非机械式的,属于非接触式加工,可以避免出现芯片破碎和其他损坏现象。
2.激光切割、划片采用的高光束质量的光纤激光器对芯片的电性影响较小,可以提高更高的切割成品率。
3.激光切割速度为150mm/s。切割速度较快。
4.激光可以切割厚度较薄的晶圆,可以胜任不同厚度的晶圆划片。
5.激光可以切割一些较为复杂的晶圆芯片,如六边形管芯等。
6.激光切割不需要去离子水,不存在刀具磨损问题,可连续24小时作业。
7.激光具有很好的兼容性,对于不同的晶圆片,激光切割具有更好的兼容性和通用性。
激光隐形切割作为激光切割晶圆的一种方案,很好的避免了砂轮划片存在的问题。激光隐形切割是通过将脉冲激光的单个脉冲通过光学整形,让其透过材料表面在材料内部聚焦,在焦点区域能量密度较高,形成多光子吸收非线性吸收效应,使得材料改性形成裂纹。每一个激光脉冲等距作用,形成等距的损伤即可在材料内部形成一个改质层。在改质层位置材料的分子键被破坏,材料的连接变的脆弱而易于分开。切割完成后通过拉伸承载膜的方式,将产品充分分开,并使得芯片与芯片之间产生间隙。这样的加工方式避免了机械的直接接触和纯水的冲洗造成的破坏。目前激光隐形切割技术可应用于蓝宝石/玻璃/硅以及多种化合物半导体晶圆。
激光属于无接触式加工,不对晶圆产生机械应力的作用,对晶圆损伤较小。由于激光在聚焦上的优点,聚焦点可小到微米数量级,从而对晶圆的微处理更具有优越性,可以进行小部件的加工;即使在不高的脉冲能量水平下,也能得到较高的能量密度,有效地进行材料加工。大多数材料吸收激光直接将硅材料气化,形成沟道。从而实现切割的目的因为光斑点较小,最低限度的炭化影响。